Privacy Policy Update
Click here to learn about the new Privacy Policy updates from Practical Components.888-388-7808
FC150JY


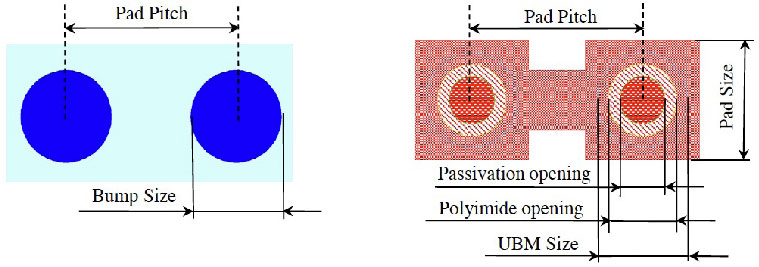
Chip Structure
- Base Layer : P-TEOS*
- Metal Layer : TiN / AI-0.5%Cu
- Passivation Layer : HDP* / P-SiN (option) Polymide
*TEOS : Tetraethoxysilane
*HDP : High Density Plasma
| Specifications | Si | Glass | |
| TYPE | A | B | B** |
| Wafer Thickness | 725±25μm | 725±25μm | 700±70μm |
| Wafer Size | 8 inch | 8 inch | 8 inch |
| Chip Size | 10.0mm ♦ | 10.0mm ♦ | 10.0mm ♦ |
| Bump pitch | 150μm | 150μm | 150μm |
| Function | Daisy Chain | Daisy Chain | x |
| Pad config | Area | Area | Area |
| Electrode | Ball Mounted Solder Bump | Cu Pillar | Cu Pillar |
| Pad Size | 100μm ♦ | 100μm ♦ | x |
| Passivation opening | φ40μm • | φ40μm • | x |
| Polyimide opening | φ60μm • | φ60μm • | x |
| UBM Size | φ80μm • | φ75μm • | φ75μm • |
| Bump Size | φ85μm • | φ75μm • | φ75μm • |
| Scribe width | 100μm | 100μm | x |
| Number of Pad | 3721pads/chip(61×61) | 3721pads/chip(61×61) | x |
| Number of Chip | 208 chips/wafer | 208 chips/wafer | 208 chips/wafer |
| • Top Side ♦ Bottom Side | |||
**Glass die do not have daisy-chain function and no alignment marks or patterns on die


